新闻详情
客服
华为研究混合3D芯片堆叠技术 或可绕过美国技术制裁!
1086 2022-05-05 08:50:14 来源: 网络 作者: IC小编
据报道,华为开发了一种芯片堆叠工艺,并申请了专利,这将比现有的芯片堆叠工艺成本低得多。不过,华为的这项技术是基于旧节点,但提高了芯片性能。而这,可能有助于华为避开美国的制裁。
美国政府将华为及其芯片供应商HiSilicon新思科技列入黑名单,现在要求所有生产芯片的公司都申请出口许可证。而且,所有半导体生产都涉及美国开发的技术,华为无法接入任何现代节点(如台积电的N5),只有依赖旧有的节点。 华为前轮值董事长郭平在最近的一次新闻发布会上说:「为此,创新的芯片封装、chiplet互连技术以及特别的3D堆叠,是公司把更多的晶体管做在一个芯片上的方式,从而在竞争力上获得更好表现。」

华为高管表示,由于现代前沿工艺技术发展相对缓慢,采用2.5D或3D封装的多芯片设计,是芯片设计师的一种通用方法,它可以把更多晶体管做在他们的产品上,这样可以满足客户在新特征和新性能方面的期待。
郭平强调,华为将继续投资于内部设计的面积增强(area enhancing)和堆叠技术。 新闻发布会公开清楚地声明,华为打算在即将推出的产品中,使用混合免费TSV3D堆叠方法,或者可能是类似的、更主流的方法。 主要的问题是,这种方法是否需要美国的先进工具或技术,毕竟,大多数制造工具使用的是源自美国的技术。
然而,是否存在代工公司,使用华为的专利技术,为其生产3D芯片封装,目前并不清楚。 但至少华为拥有一种独特的廉价3D堆叠技术,可以帮助它在不使用最新节点的情况下保持竞争力。
版权声明:
部分文章信息来源于网络以及网友投稿,本网站只负责对文章进行整理、排版、编辑,是出于传递更多信息之目的,并不意味着赞同其观点或证实其内容的真实性,如本站文章和转稿涉及版权等问题,请作者及时联系本站,我们会尽快处理。
文章标签:
华为
21080次 2023-05-29 14:18:09

35991次 2023-02-03 11:21:20

2242次 2022-04-29 17:29:28
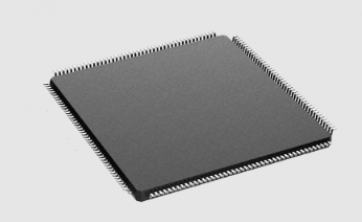
1942次 2022-04-29 14:19:50